지난 주요뉴스 한국경제TV에서 선정한 지난 주요뉴스 뉴스썸 한국경제TV 웹사이트에서 접속자들이 많이 본 뉴스 한국경제TV 기사만 onoff
-
엠케이전자, `韓뉴딜 기술혁신 선언식`에 중견기업 대표로 나선다 2020-11-27 08:45:43
및 선언 진행 본딩와이어 세계 점유 1위, 솔더볼 세계 점유 3위 기업인 엠케이전자가 중견기업과 공공연 간의 ‘한국판 뉴딜 기술혁신 협력 선언식’에 중견기업 대표로 참가한다. 27일 관련 업계에 따르면 이날 오후 14시 포시즌즈호텔 그랜드볼룸에서 개최되는 ‘중견·공공연 기술혁신 챌린지’ 추진경과 및 지원계획...
- 뉴스 > 산업
- 바로가기

-
[PRNewswire] JCET, 2020년에 2분기 연속으로 신기록 세워 2020-08-25 09:12:43
시스템-인-패키징 및 신뢰성 높은 플립 칩과 와이어 본딩 기술을 통해 모바일, 통신, 전산, 소비자, 자동차 및 산업 같은 광범위한 스펙트럼의 반도체 용도를 아우른다. JCET 그룹은 한국과 중국에 두 개의 연구개발센터, 한국, 중국, 싱가포르에 여섯 곳의 제조시설, 그리고 세계 곳곳에 판매 센터를 보유하고 있다. 또한,...
- 뉴스 > 정치·사회·국제
- 바로가기
-
엠케이전자, 반도체 넘어 2차전지로…"성장동력 본궤도" 2020-07-01 12:28:46
이 홀을 지나면서 와이어는 한층 더 얇고 강하게, 그것도 생산성과 효율성을 감안해 끊어지지 않도록 한 번에 쭉 뽑아내는 고도의 기술이 요구되는 과정. 엠케이전자의 주력소재로, 반도체 리드프레임, 실리콘칩을 연결해 전기신호를 전달하는 이 본딩와이어는 간단해 보여도 결코 간단치 않은 기술과 공정을 거쳐 고객사에...
- 뉴스 > 산업
- 바로가기

-
K-뿌리산업의 '힘'…"코로나에도 매출 늘었죠" 2020-06-03 17:59:07
본딩와이어와 솔더볼의 국산화와 고부가 신제품 개발에 주력함은 물론, 해외 영업력과 생산력, 품질을 높여 공장가동 중단으로 국내외 경쟁사의 물량 납품이 어려운 상황을 `기회`로 만든 겁니다. <인터뷰> 김형주 / 엠케이전자 차장 "국산화 개발도 중요하지만 이후 대처가 중요하다고 생각합니다. 중복납품이 힘든 국내...
- 뉴스 > 산업
- 바로가기

-
[PRNewswire] JCET 그룹, 1분기 높은 실적 달성 2020-05-01 11:56:24
2.5D/3D, 시스템-인-패키징 및 신뢰성 높은 플립 칩과 와이어 본딩 기술을 통해 모바일, 통신, 전산, 소비자, 자동차 및 산업 같은 광범위한 스펙트럼의 반도체 용도를 아우른다. JCET 그룹은 세 개의 연구개발센터, 중국, 싱가포르, 한국에 여섯 곳의 제조시설, 그리고 세계 곳곳에 판매 센터를 보유하고 있다. 또한, 중국...
- 뉴스 > 정치·사회·국제
- 바로가기
-
[PRNewswire] JCET 그룹, 2019년에 손실에서 수익으로 회복 2020-05-01 11:55:27
2.5D/3D, 시스템-인-패키징 및 신뢰성 높은 플립 칩과 와이어 본딩 기술을 통해 모바일, 통신, 전산, 소비자, 자동차 및 산업 같은 광범위한 스펙트럼의 반도체 용도를 아우른다. JCET 그룹은 세 개의 연구개발센터, 중국, 싱가포르, 한국에 여섯 곳의 제조시설, 그리고 세계 곳곳에 판매 센터를 보유하고 있다. 또한, 중국...
- 뉴스 > 정치·사회·국제
- 바로가기
-
삼성전자, 반도체 패키징도 '초격차' 지속 2019-10-07 17:21:38
와이어 본딩)과 달리 반도체 칩 상단과 하단에 머리카락 굵기의 20분의 1 수준의 전자 이동통로 6만 개를 생성해 연결하는 방식이다. 와이어 본딩 방식보다 칩 사이에 신호를 주고받는 시간이 짧아져 속도와 소비전력을 획기적으로 개선할 수 있다. 기술 개발을 통해 D램을 8단으로 쌓은 기존 제품과 같은 두께로 12개의...
- 뉴스 > 산업
- 바로가기
-
"반도체 패키징도 초격차"…삼성, 3차원 12단 기술 최초 개발(종합) 2019-10-07 10:22:25
기술은 와이어를 이용해 칩을 연결하는 기존 방식(와이어 본딩)과는 달리 반도체 칩 상단과 하단에 머리카락 굵기의 20분의 1 수준에 불과한 미세한 전자 이동통로 6만개를 만들어 연결하는 방식이다. 종이(100㎛)의 절반 이하 두께로 가공한 D램 칩 12개를 쌓아 수직으로 연결하는 고도의 정밀성이 필요하기 때문에 반도체...
- 뉴스 > 경제
- 바로가기
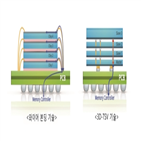
-
반도체 패키징 초격차…삼성전자, 3차원 12단 기술 최초개발 2019-10-07 10:14:20
이 기술은 와이어를 이용해 칩을 연결하는 기존 방식(와이어 본딩)과 달리 반도체 칩 상단과 하단에 머리카락 굵기 20분의 1 크기의 미세한 전자 이동통로 6만개를 만들어 연결하는 방식이다. 종이(100㎛)의 절반 이하 두께로 가공한 D램 칩 12개를 쌓아 수직으로 연결하는 고도의 정밀성이 필요해 반도체 패키징 기술 가운...
- 뉴스 > 산업
- 바로가기
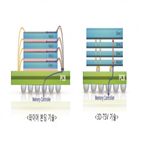
-
"반도체 패키징도 초격차"…삼성, 3차원 12단 기술 최초 개발 2019-10-07 08:49:01
기술은 와이어를 이용해 칩을 연결하는 기존 방식(와이어 본딩)과는 달리 반도체 칩 상단과 하단에 머리카락 굵기의 20분의 1 수준에 불과한 미세한 전자 이동통로 6만개를 만들어 연결하는 방식이다. 종이(100㎛)의 절반 이하 두께로 가공한 D램 칩 12개를 쌓아 수직으로 연결하는 고도의 정밀성이 필요하기 때문에 반도체...
- 뉴스 > 경제
- 바로가기